- В России поступили в продажу обновлённые... (657)
- Новая статья: Обзор тройного складного... (561)
- Календарь релизов 10 – 16 февраля:... (429)
- В Steam начался фестиваль локальных... (707)
- В Россию официально начнут завозить... (717)
- Оказывается, потребляющую 600 Вт GeForce RTX... (717)
- «Человечество может исчезнуть за 10 лет»:... (747)
- Ждать более дешёвых видеокарт GeForce RTX 50... (732)
- Автор самого популярного мода для Elden Ring... (717)
- Шведские учёные нашли способ сделать зимние... (698)
- Частный лунный аппарат Blue Ghost начал... (745)
- Федеральная комиссия по связи США готовится... (726)
- Над Microsoft нависла угроза крупного штрафа... (623)
- Первый хорватский спутник CroCube передал... (644)
- Греческие учёные создали оптическую систему... (726)
- Samsung перейдет на кремний-углеродные... (697)
Можно создать чип, который примерно в семь раз крупнее GPU Nvidia Blackwell. Broadcom представила платформу 3.5D eXtreme Dimension System in Package
Дата: 2024-12-07 19:22
Компания Broadcom представила платформу с довольно длинным названием 3.5D eXtreme Dimension System in Package (XDSiP), которая выделяется тем, что позволяет создавать чудовищные, по меркам обычных чипов, чипы.
 фото Broadcom
фото Broadcom Речь тут о более чем 6000 квадратных миллиметров. Конечно, это не микросхемы Cerebras размером с iPad, но, для сравнения, самые крупные GPU — это около 800 квадратных миллиметров или чуть более.
Как сказано в пресс-релизе, новая платформа позволяет клиентам разрабатывать пользовательские ускорители для ИИ следующего поколения. На одной подложке с основным чипом располагается до 12 микросхем памяти HBM.
 фото Broadcom
фото Broadcom Broadcom 3.5D XDSiP использует технологию упаковки CoWoS-L от TSMC, которая обеспечивает максимальный размер интерпозера примерно в 5,5 раз больше размера сетки (около 858 кв. мм), или 4719 кв.мм для вычислительных чиплетов, чиплетов ввода-вывода и до 12 стеков памяти HBM3/HBM4. Для максимизации производительности Broadcom предлагает разбить конструкцию вычислительных чиплетов и накладывать один логический чиплет на другой с использованием гибридного медного соединения.
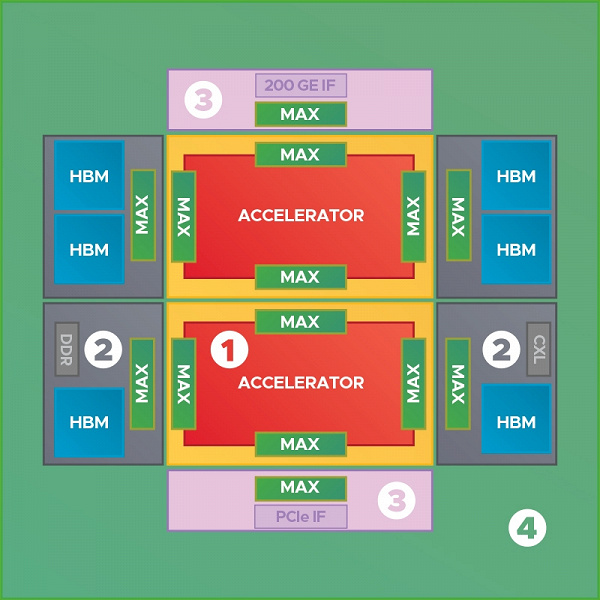 фото Broadcom
фото Broadcom В данном случае чиплеты тут располагаются лицом к лицу (F2F). Подход F2F обеспечивает до семи раз больше сигнальных соединений, чем обычно, и более короткую маршрутизацию сигналов, снижает энергопотребление в интерфейсах «кристалл-кристалл» на 90%, минимизирует задержку в 3D-стеке и обеспечивает дополнительную гибкость для проектных групп для разделения архитектуры ASIC между верхним и нижним кристаллами.
Подробнее на iXBT
Предыдущие новости
Тот же Geely Monjaro, но с шильдиком Renault. В России уже можно заказать Renault Grand Koleos
Renault Grand Koleos, представляющий, по сути, слегка подретушированный Geely Monjaro, стал суперхитом в Южной Корее, а сейчас внедорожник можно купить и в России. Дилер из Благовещенска готов поставить автомобиль под заказ. Фото: Renault Пробег предлагаемого Grand Koleos составляет 2000 км, но на фото машины видны транспортировочные пленки – как у новой. Grand Koleos...
iPhone 17 Air будет самым тонким смартфоном на рынке за много лет
Похоже, теперь мы знаем, насколько действительно тонким будет грядущий iPhone 17 Air. фото WCCF Tech Согласно данным Bloomberg, новинка будет на 2 мм тоньше iPhone 16 Pro. Толщина последнего составляет 8,25 мм, то есть речь идёт примерно (или точно) о 6,25 мм для iPhone 17 Air. Для сравнения, самым тонким iPhone в истории на данный момент является iPhone 6 с толщиной...
Intel вообще разучилась производить чипы? Важнейший для компании техпроцесс 18A находится в катастрофическом положении
Компания Intel не раз акцентировала внимание на том, что техпроцесс 18A для неё крайне важен. Она делает на него большие ставки как в контексте производства собственных CPU, так и в контексте выпуска чипов других компания. Однако, похоже, у Intel снова проблемы. фото WCCF Tech Сообщается, что показатель выхода годной продукции у Intel 18A сейчас составляет всего менее 10%,...
Нынешний Mac mini и так очень компактный, но мог быть ещё меньше. Проблемой стал нагрев SoC M4 Pro
Новый мини-ПК Apple Mac mini на основе SoC M4 очень компактный. Однако он мог быть ещё меньше. фото Apple Insider Как стало известно, Apple рассматривала ещё более компактный вариант, но всё упёрлось в охлаждение версии с SoC M4 Pro. Если бы новый Mac mini был доступен только с базовой платформой M4, его можно было бы сделать меньше без большого ущерба для охлаждения, но вот...